Application : 반도체 Wafer Bumping RDL/UBM 공정

Cu Plating Process

Cu 도금 장비 구성
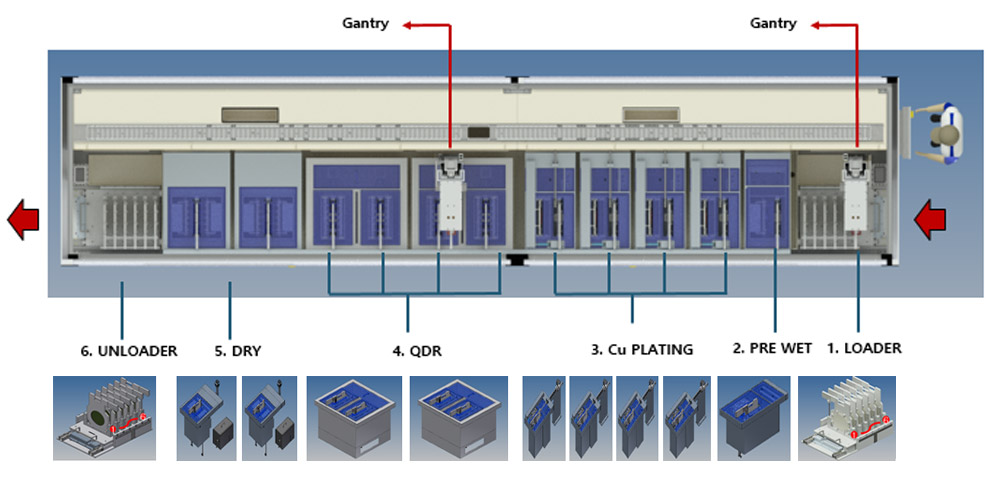
Wafer Cu도금 장비 3D 설계
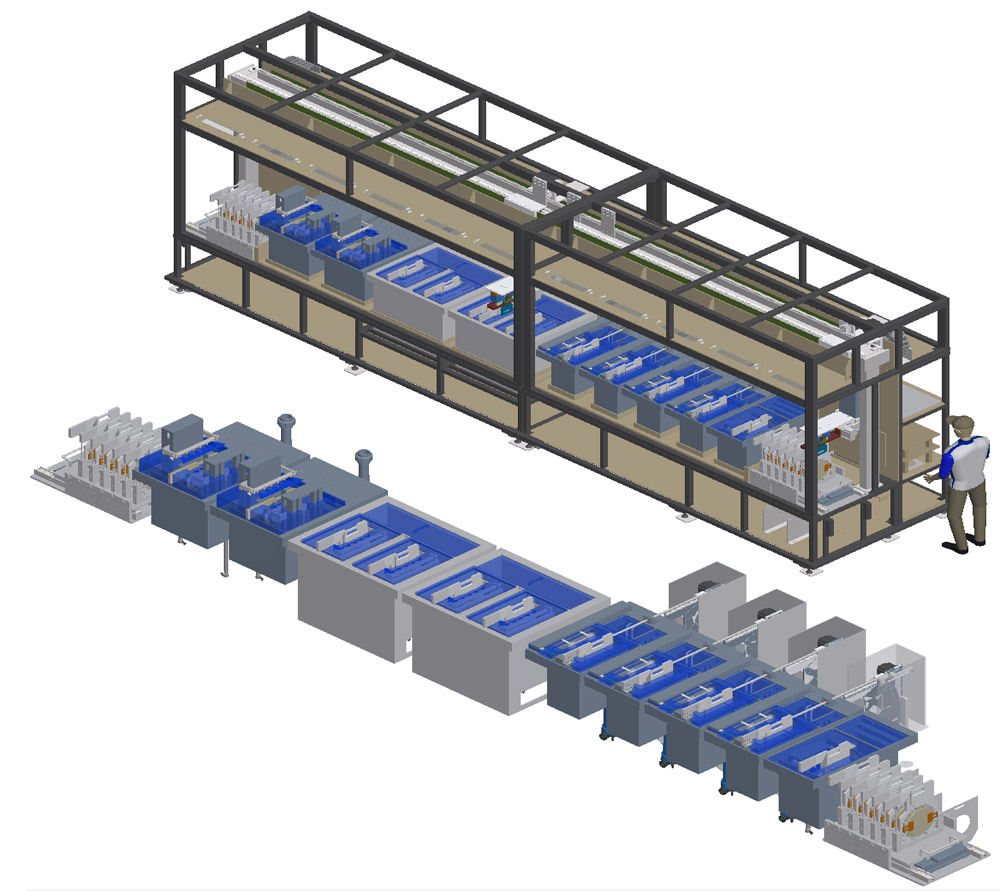
– 구성: 도금/Rinse Bath, 제어, Wafer Load/Unload.
— 도금장비 주요 특징
| — | 1.5 -> 3ASD 까지 고속 Thick RDL도금 가능. |
|---|---|
| — | Wafer 6매/1회 연속 자동 도금가능. (Loading : Manual) |
| — | 소량 다품종 도금 가능. (1~6 제품 Recipe 동시적용 가능) |
| — | 도금액 절감형 Bath구조 제작 가능. |
| — | Jig 국내 제작 및 Repair 대응 가능. |
| — | 국내제작, 국내/해외 Setup, 신속한 A/S 가능. |
— TETOS 도금장비 Advantage
| — | FPCB Cu증착/도금 경험을 바탕으로 기존 Cu도금 장비업체와 동등수준의 품질확보. 특히, Power Device관련 두꺼운 Cu RDL도금 조건에서도 우수한 Cpk 관리 가능함. |
|---|---|
| — | 고객요구사양 맞춤형 장비설계 및 제작 가능, 도금액 업체 연계 도금조건 Setup가능. |
Other Services
-
마이크로LED 측면배선
Display용 기판 3면 동시 메탈 증착 (측면 배선 기술) — Product Application ㆍ기판측면배선 TV ㆍ기판/Ball/IC증착 Display용 기판 3면 동시 메탈 저온증착 기술
