Application : 半导体 Wafer Bumping RDL/UBM 过程
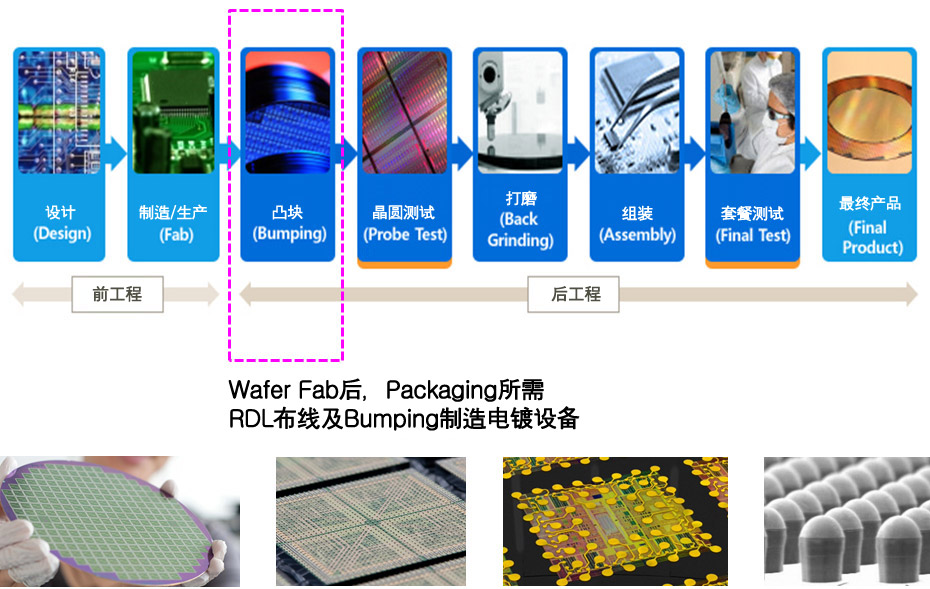
Cu Plating Process

电镀设备构成
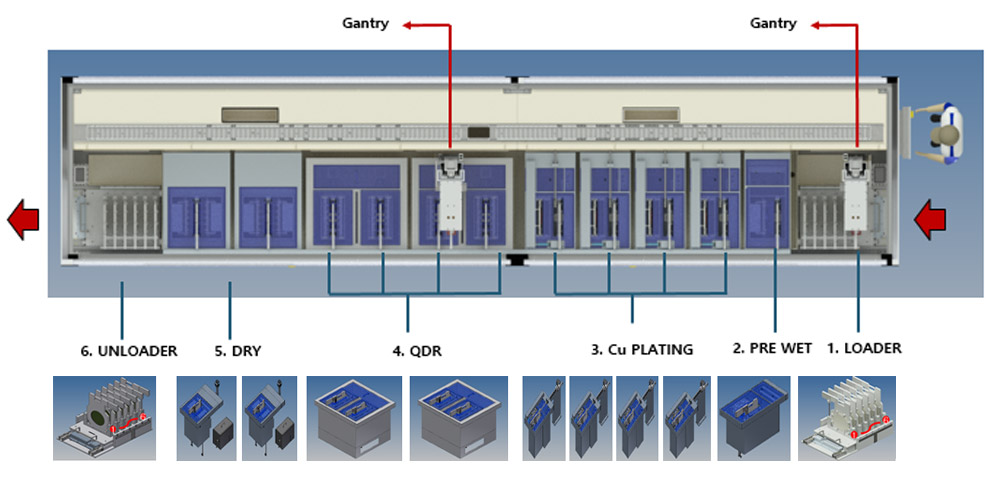
Wafer 电镀设备/3D设计
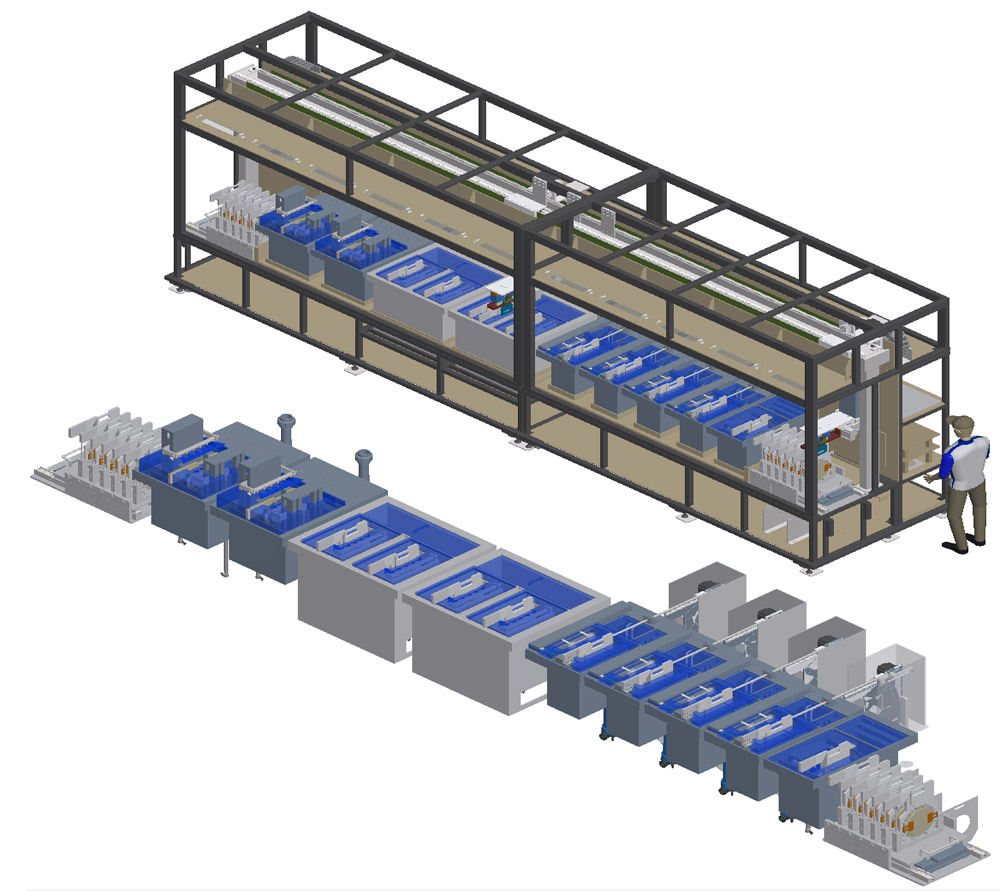
– 构成: 电镀/Rinse Bath, 控制, Wafer Load/Unload.
— 电镀设备主要特征
| — | 可进行至1.5 -> 3ASD的高速Thick RDL电镀。 |
|---|---|
| — | 可进行Wafer 6张/1次连续自动电镀。(Loading : Manual) |
| — | 可进行少量多品种电镀。(可同时适用1~6产品Recipe) |
| — | 可制作电镀金额节约型Bath结构产品。 |
| — | 可进行Jig国内制造并进行Repair应对。 |
| — | 国内制造、国内/海外Setup并可提供快速A/S。 |
— TETOS 电镀设备优点
| — | 基于FPCB Cu溅镀/电镀经验,保证拥有与现有Cu电镀设备企业同等水平的质量。 特别是,可在Power Device相关较厚的Cu RDL电镀条件下,进行优秀的Cpk管理。 |
|---|---|
| — | 可进行符合顾客要求规格的设备的设计与制作,电镀金额,可配合企业相关条件的电镀条件的 Setup。 |
